OSRDA開發受託
MONSTER PAC® 核心技術
Bump在材料上和無損傷接合
我們的MONSTER PAC®是世界首席的Cutting-edge技術
我们的实力
1
MONSTER PAC®
Bump On Material
在基板等材料上形成Bump。使用導電膏接合。

2
Conventional Flip Chip
Bump On Wafer
低溫低壓接合方式。設法確保接合強度了、所以接合強度充分。 這低溫低壓無損傷接合方式就是對5G装置有的脆弱性唯一的解決方案。
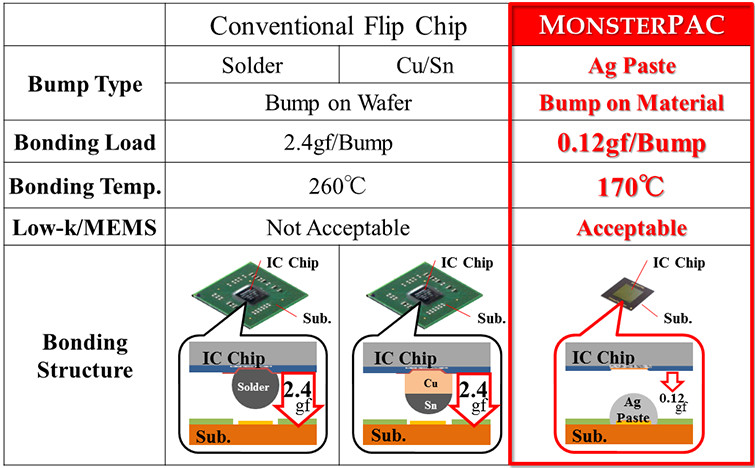
特徵
Low-k装置的組装
按照高速化、高機能化的市場需求、LSI製造的走線規則是往微細化。為了把高速化的重要參數的綫路間容量減少、層間絶縁膜要多孔化。 因此對應力會脆弱、結果Low-k絶縁膜容易損傷。
傳統組装技術的話、無法避免對Low-k絶縁膜損傷。 但因為Connectec Japan的MONSTER PAC®是無損傷接合方式、所以可避免對Low-k絶縁膜損傷組装。
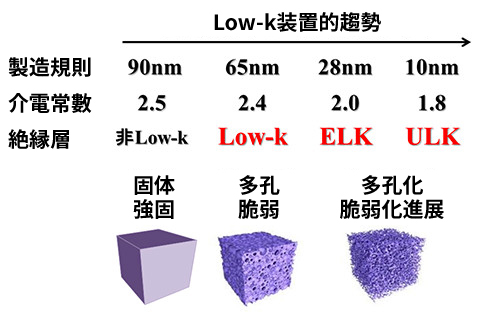
MEMS装置的組装
個体結構和可動結構
傳統組装技術的話、無法實装對物理上的損傷脆弱的MEMS/NEMS装置。左圖是單片結構的SAW濾波器事例、MEMS装置也固体結構的話、傳統組装方式也可以實装。
但像右圖的MEMS装置、可動結構的MEMS装置是因為物理上脆弱、所以傳統組装方式無法實現實装。
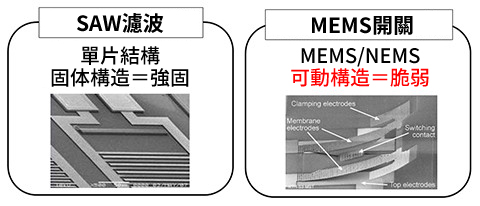
Low-k装置的趨勢
Connectec Japan®有的核心技術MONSTER PAC®是因為低溫低壓無損傷接合方式、所以MEMS/NEMS装置也可以Flip Chip組装。
因為也有今後的高機能化的需求、可能也有MEMS装置和LSI合一的需求。 MONSTER PAC®可對應有機基板、軟性材料、陶瓷基板等各種基板

MONSTER PAC®系列
按照目前為止的具体的客戸開発需求、我們把各種標準款上系列了。
關於詳細的内容、請務必跟Connectec Japan®聯繫。
