Dev. Ex.
High Yield CoC for DRAM and CPU
The DRAM is bonded on the CPU and bonded on the board.

specification
| Special Stipulations | MONSTER PAC® 170°C low temperature bonding |
Conventional method
CoC bonding by solder Flip chip bonding by solder ▼ (1) When installing DRAM (CoC) on the CPU, solder bumps of the CPU melt and oxidize (2) When the DRAM bonds a CoC CPU on the board, solder remelts and DRAM falls (3) High temperature (260°C) causes the board to warp and voids ▼ Not feasible
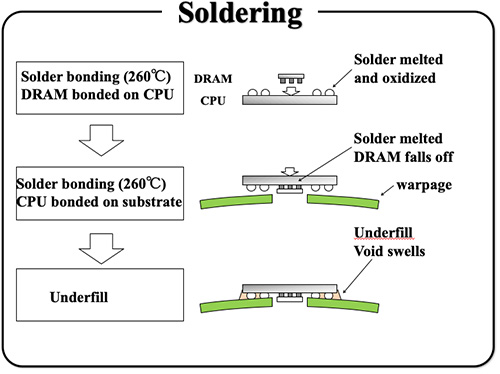
MONSTER PAC® Method
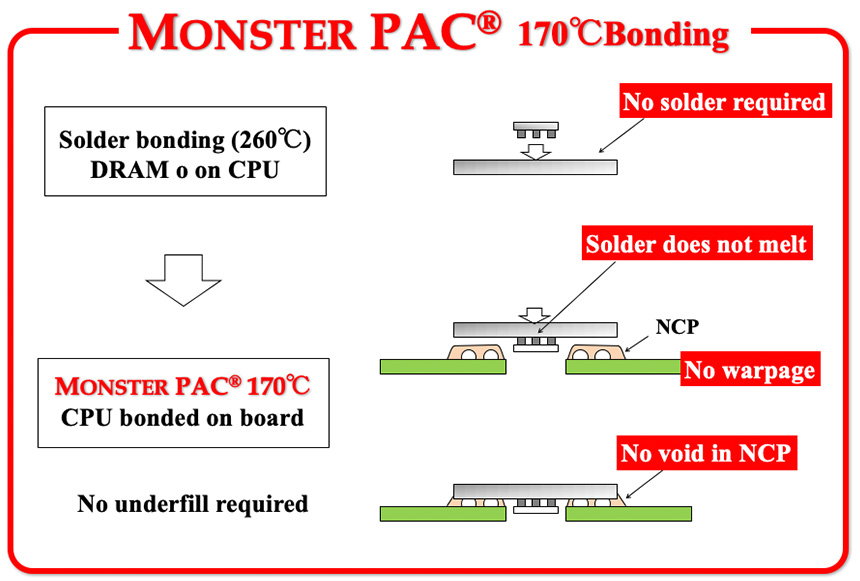
CoC bonding by solder and Low-temperature and low-load MONSTER PAC Ⓡ 170°C Flip chip bonding combination
▼
(1) Because CPU solder bumps are not necessary, oxidation of solder bumps does not occur during CoC
(2) When the DRAM bonds a CoC CPU on the board, for 170°C to be applied by conductive paste and NCP, DRAM does not fall
(3) Low temperatures do not cause board warpage
▼
Feasible