開発事例
DRAMとCPUの高歩留CoC
CPU上へDRAMをCoC実装し、更に基板へ実装する。
仕様
| 特徴 | MONSTER PAC® 170℃低温実装 |
従来工法
・はんだによるCoC実装
・はんだによるフリップチップ実装
▼
(1)CPU上へDRAMを搭載(CoC)する
CPUのはんだバンプが溶けて酸化
(2)DRAMがCoCされたCPUを基盤に搭載する際、
はんだが最溶融し、DRAMが落下する
(3)高音(260℃)のため基盤が反り、ボイドが発生する
▼
実現不可能

実装事例
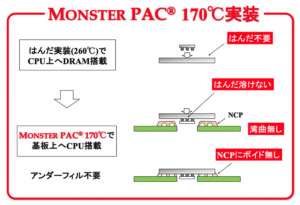
・MONSTER PAC®
はんだによるCoC実装と
低音・低荷重のMONSTER PAC®170℃による
フリップチップ実装の組み合わせ
▼
(1)CPUはんだバンプは不要のため、
CoCの際にははんだバンプの酸化は発生しない
(2)DRAMがCoCされたCPUを基盤へ搭載する際、
誘電ペーストとNCPにより170℃実装するため、
DRAMの落下は発生しない
(3)低音のため基盤の反りも発生しない
▼
実現可能