開発受託
MONSTER PAC® Core Technology
世界初・世界唯一の MONSTER PAC®コアテクノロジー
これまでの技術では、ウエハ(チップ)側にバンプを形成していました。
この場合、バンプはウエハ工程での作り込みが必要です。対応する設備も前工程用の設備が必要となり、工期も長くコスト高になるという欠点がありました。また、バンプの材料がはんだですので、基板との接合のために、260℃~270℃という高い温度と高い荷重が必要でした。そのため、物理的なダメージに対して脆弱なLow-kデバイスやMEMSチップに対して、深刻な影響を与えてしまうという欠点もありました。
これらの問題を解決したのが、世界初・世界唯一のMONSTER PAC®コアテクノロジーです。
強み
バンプ・オン・マテリアル
基板等の材料側にバンプを形成し、接合は導電性ペーストによって行います。

ダメージフリー接合
低温かつ低荷重で接合します。接合の強度を保つための工夫がされており、強度も十分です。この低温・低荷重のダメージフリー接合は、5G世代のデバイスが持つ脆弱性に対する唯一の解です。
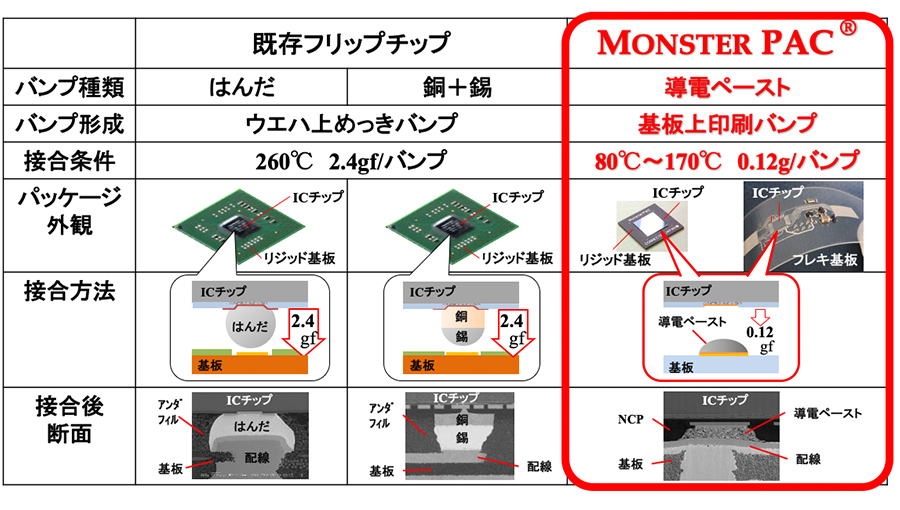
特徴
既存のプロセスに比べ、リードタイム3分の1、稼働費用13分の1、世界初の革新的製造プロセスです。

PETフイルム基板のようなフレキシブルあるいはストレッチャブル基板に実装できる世界唯一の製造プロセスです。

これまでにお客様からいただいた開発のご要求をベースに、各種標準タイプをラインナップしております。
詳細につきましては、コネクテックジャパンまでお問い合わせください。
