開発事例
大面積センサの狭ギャップ実装
12mm□のLSIチップを4つ、30㎛のギャップで実装し集合センサを実現する。
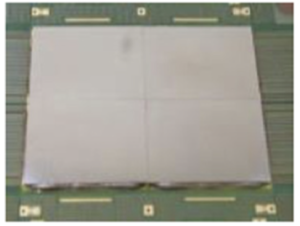
仕様
| 特徴 | MONSTER PAC® 170℃低温実装 |
従来工法1
ACFボンディングによる実装
▼
(1)大面積のため100kgf以上の高荷重が必要
(2)ACFボンディングのため、300μm以上のギャップ必要
▼
実現不可能
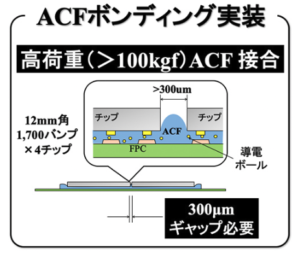
従来工法2
はんだによるフリップチップ実装
▼
はんだ溶融温度が260℃のため
フィルム基盤(FPC)が熱で変形する
実装事例
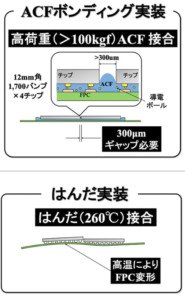
MONSTER PAC® 工法
低音・低荷重のMONSTER PAC® 170℃による実装
▼
誘電ペーストとNCPによる接合温度170℃実装
フィルム基盤の変形が無い
大面積LSIチップを低荷重で接合できる
▼
実現可能